Bernstein認爲,隨着AI芯片加速迭代,英偉達相較於其他廠商的領先優勢將進一步擴大,台積電的先進封裝優勢料將延續,ASIC芯片市場有望擴張。
本文作者:李笑寅
來源:硬AI
隔夜美股市場,半導體巨頭台積電盤中市值站上1萬億美元,臺股股價也在週一創下歷史新高,顯示市場對高端芯片尤其是AI芯片的需求依然旺盛。
7月8日,投行Bernstein分析師Mark Li、Stacy A. Rasgon等人發佈研報,總結了到2027年的AI芯片技術變革路線圖,並就設計架構、晶圓節點、HBM和高級封裝這四個領域進行了分析,並討論了其可能帶來的影響。
AI芯片加速迭代,英偉達或成最大贏家

Bernstein認爲,AI芯片將加速發展,尤其是英偉達已經將迭代速度加快到“一年一更”。
技術路線圖一顯示,英偉達從Blackwell到Rubin的飛躍性變化,包括架構、節點、HBM和封裝在大約1年內全部改變——節點從N4到N3,HBM從3E到4,封裝尺寸從更小(單個CoWoS晶圓容納16個B100/B200)到更大(單個CoWoS晶圓上容納高個位數到10個Rubin)。
此外,英偉達HBM從8hi/192GB升級到12hi/288GB的更新將在6個月內完成。
相比之下,AMD的步伐要稍慢一些:MI325X約比MI300X晚一年推出,並且只會升級內存;到2025年,MI350X將主要升級到N3節點,但內存和容量保持不變,仍爲HBM3E 288GB。
報告指出,這將帶來第一個影響:隨着AI芯片加速迭代,英偉達相較於其他廠商的領先優勢將進一步擴大。


第二個影響是,CPU與GPU整合、內存和邏輯整合的趨勢。比如英偉達就在其GB200中集成了CPU和GPU,幫助其基於Arm的CPU利用GPU領域的領先優勢。
技術路線圖三顯示,爲了進一步推動數據傳輸的發展,HBM4可能會開始提供基礎芯片基礎上的客戶定製服務,由於其基礎裸片(邏輯裸片)定製化需要更長的生產週期,因此在HBM內部進行邏輯和存儲的整合或許會成爲一大趨勢。
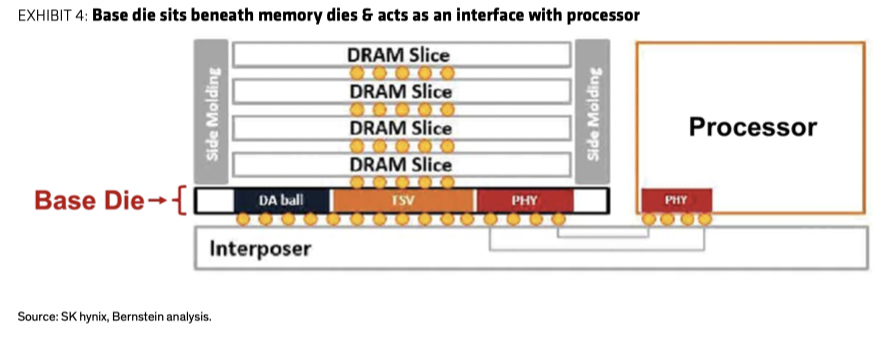
台積電的先進封裝優勢料將延續
報告指出,台積電的技術優勢仍將延續下去,從CoWoS-S發展到CoWoS-L。
據悉,CoWoS-S整個中間件都使用硅,而CoWoS-L僅在密集金屬線穿過的區域使用硅作爲“橋樑”,其餘部分則用模塑化合物代替。
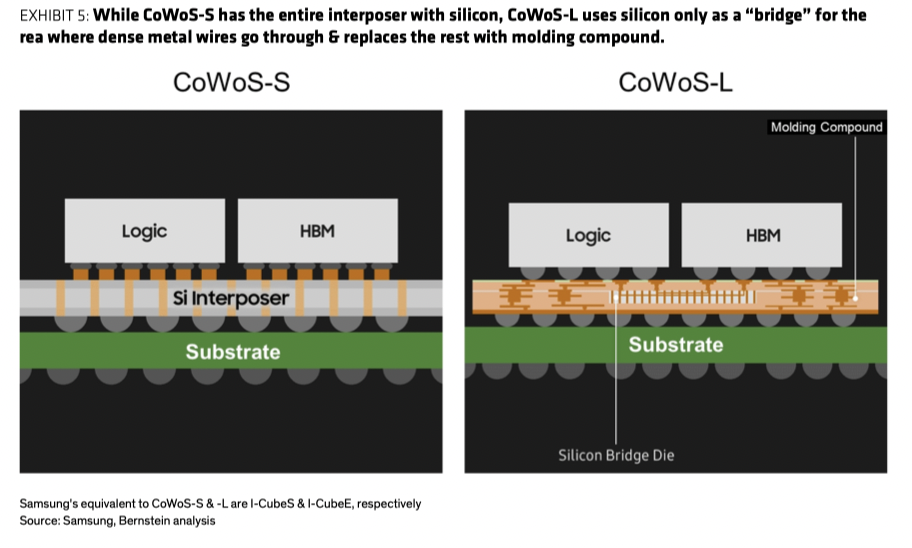
報告預計,未來幾乎所有的AI芯片都將使用台積電的CoWoS進行封裝,預計客戶下一步將拓展至微軟(部分通過Marvell)和Meta(通過博通)。這也將帶來第三大影響:隨着技術的不斷進步和客戶群的不斷擴大,台積電在先進封裝領域的領先地位即使不會擴大,也會保持下去。
第四,希望三星能及時跟上HBM3E的步伐。目前,三星尚未宣佈其HBM3E的認證,特別是獲得英偉達的認證。
報告認爲,儘管三星在HBM3E的起步較晚,但HBM3E的窗口期仍將爲三星提供追趕的機會。英偉達在2025年的幾乎所有芯片以及2026年其他廠商的芯片,很可能仍將使用HBM3E。
鍵合技術需求前景樂觀、ASIC市場擴張
隨着節點過渡的持續,報告預計,AI將使N2成爲一個“超級節點”,但這低估了產量和成本負擔——隨着水平擴大,先進封裝獎變得越來越困難——這使得鍵合技術、尤其是混合鍵合技術,在垂直堆疊領域中變得至關重要。
Bernstein對鍵合技術的長期前景持結構性樂觀態度。報告認爲第五點影響即爲:AI芯片和其他相關應用(晶圓到晶圓、芯片到晶圓或芯片到芯片)將帶來更大的鍵合技術市場,
第六,面板級封裝 (PLP) 比晶圓級封裝更能橫向擴展封裝,因前者能保證更好的水平可擴展性,但這一變革需努力,所需時間可能要比預期的久。
報告認爲,三星擁有晶圓和麪板,並正試圖通過PLP創造領先優勢,在這方面應該比英特爾和台積電更有優勢。
最後,對於ASIC芯片提供商而言,AI芯片的激增將吸引新的進入者,同時也將極大地拓展市場。
報告表示,受市場增長的吸引,許多公司正在進入ASIC(高性能專用集成電路)芯片領域,因其硬件規格更爲簡單,同時在工作效率和成本上也具有優勢,被視作GPU可行的替代品,包括亞馬遜、微軟、Meta在內的科技巨頭都在開發ASIC芯片。
不過,由於ASIC芯片的受衆大多是互聯網公司或過去沒有太多經驗的公司,他們需要ASIC服務供應商幫助開發定製芯片。
報告指出,目前博通在這一領域明顯處於領先地位,其收入高達數十億美元,客戶包括谷歌、Meta等,此外,因在SerDes IP和先進節點封裝方面技術能力較強,聯發科也具備一定競爭力。
